全自动晶圆测厚仪
n产品简介
全自动晶圆分拣机是全自动的多功能测量分拣设备,可根据客户要求进行定制,多种功能均可实现,可通过电容法测量厚度,TTV、Bow、Warp的数值,通过涡流法获得整个晶圆的电阻率,也可以获得晶圆载流子类型信息和表面粗糙度。该设备是一种大型台式机台,在测量时,晶圆片会通过机械手自动从晶圆盒中移动到仪器内部进行测试,然后根据recipe和测量结果进行分拣,自动分拣到不同的晶圆盒中。
n原理简介:涡流法+电容法+表面光电压+激光共聚焦
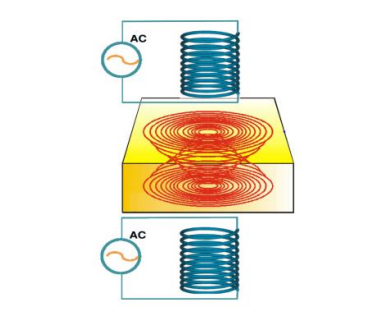
全自动分拣机采用非接触式涡流法。采用一个开放式的高频线圈的磁力线穿透硅材料并产生涡流,该涡流会造成振荡器的功率损失,功率损失与样品的电导率成正比,据此可以计算出电阻率。
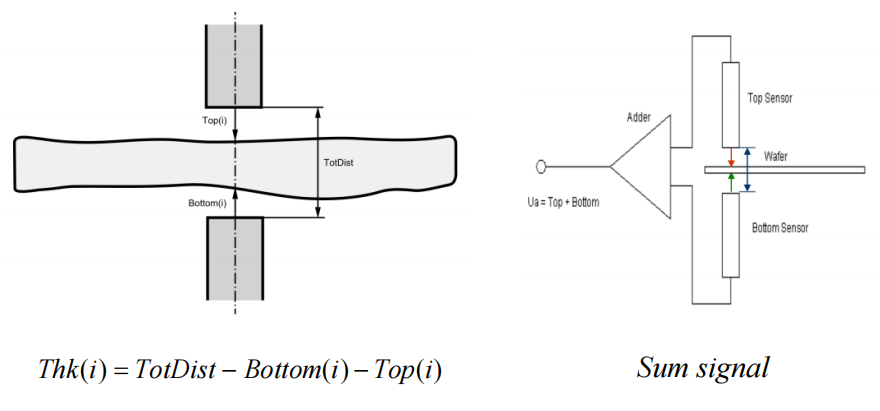
全自动分拣机采用一对电容传感器原理进行测厚。一对电容传感器的距离是一定的,当晶圆放置在电容传感器之间后,可获得上表面与上探头的距离,下表面距离下探头的距离,从而可得到晶圆的厚度。
全自动分拣机采用表面光电压的原理测量载流子扩散长度,判断载流子是否被污染。
在自动激光聚焦原理中,会聚光从激光二极管聚焦到样品表面。反射光被引导到焦点检测器,该检测器测量从理想焦点到几纳米范围内的偏差。焦点的偏差会产生一个错误,用于重新聚焦目标。物镜的位置代表高度的绝对测量值。

n主要技术参数
晶圆直径 150mm,200mm , 300 mm
机器人径向范围 14.4 inch
再现性 +/-25μm
MTBF >75,000 h
洁净度要求 class 1
文字识别 OCR
n模块选择(均为最大范围,需要根据情况选配)
MX10系列
晶圆尺寸 4-12寸
厚度要求 300-850μm
厚度分辨率 10nm
厚度精度 ±20nm
TTV精度 ±50nm
MX20系列
晶圆尺寸 2-12寸
厚度要求 200-1000μm
warp 要求 最大1000μm
厚度精度 ±500nm
TTV精度 ±300nm
MX60系列
晶圆尺寸 12寸以下
厚度要求 350-900μm
电阻率 0.001-5E+9Ω·cm
MX70系列
晶圆尺寸 12寸
厚度要求 680-870μm
粗糙度精度 ±10nm
波纹度精度 ±300nm


-
三维表面形貌仪
-
Mountains分析软件
-
微纳米力学测试系统
-
摩擦磨损试验机
-
SIC晶锭滚磨机/晶圆减薄机
-
CMP化学机械抛光/后清洗机
-
晶圆粘片机
-
临时键合机/解键合机
-
晶圆厚度/三维形貌/膜厚测量系统
-
表面颗粒度检测系统
-
原子力显微镜
-
拉曼显微镜
-
红外光谱仪
-
扫描超声显微镜
-
4D生物显微镜
-
晶圆AOI系统
-
晶圆电阻率/方块电阻测量仪
-
纳米压印系统
-
光栅尺寸无损检测仪
-
磁控溅射/热蒸发/电子束镀膜系统
-
LPCVD/PECVD
-
干法刻蚀
-
等离子灰化去胶系统
-
晶圆匀胶机/喷胶机
-
晶圆烤胶系统(热板)
-
湿法(显影刻蚀清洗)系统
-
晶圆贴片机/贴膜/解胶机
-
棱镜耦合仪
-
快速退火炉/真空高温炉
-
光刻胶边缘分析
-
划片机
-
平面磨床/金属研磨机
-
接触角测量仪