REAL RTP 200型快速退火炉
型号: Real RTP 200
产地:韩国
关键词:快速退火炉
n产品简介:
REAL RTP200型快速退火炉是韩国ULTECH公司的一款8寸片快速退火炉,采用革新的加热技术,可实现真正的基底温度测量,不需要采用传统快速退火炉的温度补偿,温度控制精确,温度重复性高,客户包括国际上许多半导体公司及知名科研团队,是半导体制程退火工艺的理想选择。
n技术特色:
- 真正的基片温度测量,无需传统的温度补偿
- 红外卤素管灯加热
- 极其优异的加热温度精确性与均匀性
- 快速数字PID温度控制
- 不锈钢冷壁真空腔室
- 系统稳定性好
- 结构紧凑,小型桌面系统
- 带触摸屏的PC控制
- 兼容常压和真空环境,真空度标准值为5×10-3Torr,采用二级分子泵真空度低至5×10-6Torr
- 最高3路气体(MFC控制)
- 没有交叉污染,没有金属污染
n真实基底温度测量技术介绍
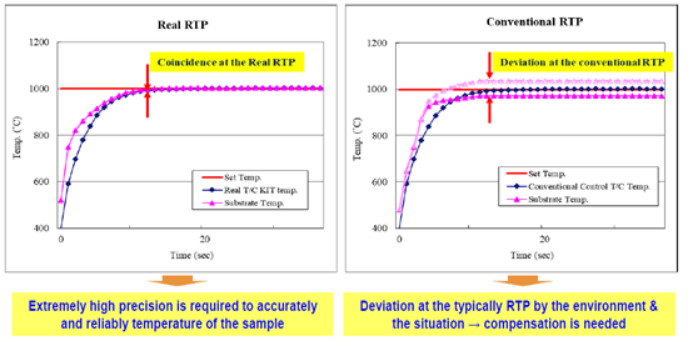
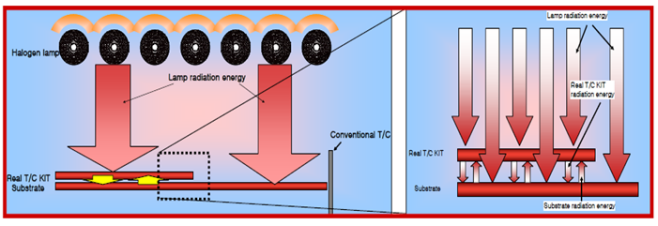
如上图,由阵列式卤素灯辐射出热量经过石英窗口到达样品表面,样品被加热,传统的快速退火炉采用热电偶进行测量基片温度,由于热电偶与基片有一定距离,测量的不是基片真实的温度,必须进行温度补偿。
REAL RTP200型快速退火炉采用专用的一根片状的Real T/C KIT进行测温,如上图,接触测温仪与片状Real T/C KIT相连,工作时片状Real T/C KIT位于样品上方很近的位置,阵列式卤素灯辐射出热量经过石英窗口到达样品表面,样品被加热,片状Real T/C KIT同时被加热,由于基片与Real T/C KIT很近,它们之间也会进行热量传递,并很快达到热平衡,所以片状Real T/C KIT测量的温度就无限接近基片真实的温度,从而实现基片温度的真实测量。
n主要技术参数:
- 基片尺寸:8英寸
- 基片基座:石英针(可选配SiC涂层石墨基座)
- 温度范围:150-1250℃
- 加热速率:10-120℃/秒 硅晶圆
10-30℃/秒 SiC涂层石墨基座上的衬底
- 控制区:6个区
- 温度均匀性:≤±1.5% (@800℃, 无SiC涂层石墨基座的硅片)
≤±1.0% (@800℃, SiC涂层石墨基座上的衬底)
- 温度控制精度:≤ ±3℃
- 温度重复性:≤ ±3℃
- 真空度:5.0E-2 Torr / 5.0E-6 Torr
- 气路供应:标准1路N2吹扫及冷却气路,由MFC控制(最多可选3路)
- 退火持续时间:≥35min@1250℃
- 温度控制:快速数字PID控制
- 尺寸:1300mm*820mm*1300mm
n基片类型:
- Silicon wafers硅片
- Compound semiconductor wafers化合物半导体基片
- GaN/Sapphire wafers for LEDs 用于LED的GaN/蓝宝石基片
- Silicon carbide wafers碳化硅基片
- Poly silicon wafers for solar cells用于太阳能电池的多晶硅基片
- Glass substrates玻璃基片
- Metals金属
- Polymers聚合物
- Graphite and silicon carbide susceptors石墨和镀碳化硅的石墨基座
n应用领域:
离子注入/接触退火,快速热处理(RTP),快速退火(RTA),快速热氧化(RTO),快速热氮化(RTN),可在真空、惰性气氛、氧气、氢气、混合气等不同环境下使用,SiAu, SiAl, SiMo合金化,低介电材料,晶体化,致密化,太阳能电池片键合等。




